
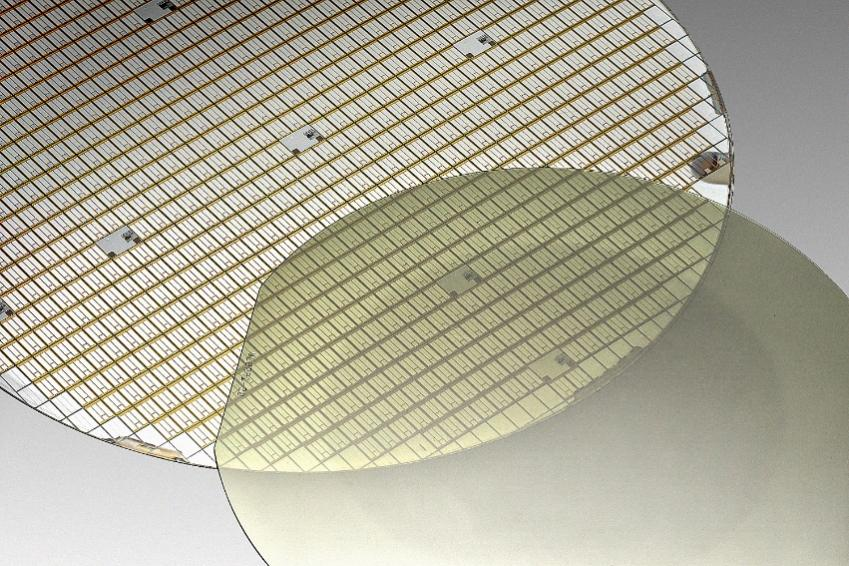 本文的上述地址:从MOSFET,二极管到电源模块,功率半导体产品是我们生活中无数的无数电子设备。从医疗设备和改良的能源基础设施到个人电子和电动车辆(EV),它们的性能和可靠性可确保各种设备的持续运行。第三代宽带隙解(WBG)领先于半导体技术,例如使用硅杆(SIC)。与传统的硅晶体管(SI)相比,SIC的良好物理特性使基于SIC的系统可显着减少损失并加速过渡到较小的形态。由于SIC在市场上是相对较新的,因此一些工程师犹豫不决在确定技术可靠性水平之前从SI到SIC。但是,等待本身也会带来风险 - 因为硅carbaan提高了性能,因此采用技术的延迟会导致失去优于竞争市场的优势。在本文中,我们探讨了SIC半导体产品如何实现高质量和可靠性,以及SIC制造商为确保可以将其解决方案置于市场上的巨大努力,这不仅可以提高产品性能,还可以确保良好的可靠性。 SIC半导体之间有什么区别?在化学水平上,SI和SIC之间的差异是碳原子的唯一增加。但是,与较弱的钻石类型相比,它导致SIC晶圆是wurtzite型原子结构更加困难。这种结构差异使SIC具有提高机械稳定性,出色的导热率,较低的热膨胀系数和在高温下较大的频带。增加的层间带宽会导致半导体从绝缘状态转移到导电状态到更高的阈值。第三代半导体的移动阈值范围在2之间。3个电子伏(EV)和3.3电子伏(EV),而第一代和第二代半导体的移动阈值在0.6至1.5 eV之间。 。因此,它们具有较高的稳定性,更高的可靠性,通过降低功率损失来提高效率,并且较高的温度阈值与硅半导体相比。对于电子行业,它可以提高现有设计的效率,并促进电动车辆的开发,并转换能量转换为更高的电压。这将带来更多的好处,例如减少原材料和冷却要求(由于电流减少到相同的功率),减少系统尺寸和重量,并减少电动汽车的充电时间。 。这对于关键能源基础设施(例如快速速度直流,电池能量存储系统和工业太阳逆变器)的组件尤其重要。从严格的停机时间维修到丧失品牌声誉,甚至更大的损失或损坏,确保这些物质的可靠性很重要。在高压SIC应用中,常见的障碍率相对较大。诸如功率周期,热不稳定性和瞬态,电子运动和低功率场之类的因素会导致在设备整个寿命中的半导体过早故障。偏置温度不稳定性(BTI)BTI是累积影响硅产品可靠性的常见现象。在介电界面中或附近,由于界面的界面陷阱的出现,这种现象将导致抗性增加,从而降低阈值电压并降低运动速度。负偏置温度不稳定性(NBTI)是MOSFET可靠性的主要问题之一,通常逐渐以晶体管年龄的形式出现。如果闸门到源电压为负或栅极为AP,则这对于设备尤其明显带有负偏置电压。时间取决于氧化物分解门(TDDB)TDDB是指由于持续的施加电压电压以及操作过程中地球电磁辐射的影响,因此氧化门可能会损坏栅极氧化。这是一种基于衰老的失败的机制,它限制了半导体产品的使用寿命。强度和热量会影响设备中的剧烈电循环会增加MOSFET的直接应力,并会产生超出击穿电压的电压尖峰。虽然抑制措施可以帮助减少手术随着时间的影响,但即使动态压力较弱也会影响设备的可靠性。由于半导体材料本身的结构是操作的关键,因此当基板的不同区域冷却并以不同的速度撤退时,强烈和重复的热周期可能会损害该物质。由SIC MOSFET体二极管C的应力引起的双极性双极积累导致偏置向前流过人体二极管引起的状态电阻“ ON”的增加。该积累偶尔显示为正向电压漂移或闭合状态下增加的泄漏电流。最常见的是,这种激活是由激活现有的外延层晶体晶体位错(BPD)引起的,可以通过合理设计外xial层和在分娩过程中进行扫描来预防。确保SIC制造商之一Onemi的半导体可靠性,以确保将SIC产品藏在随后的一代应用程序的性能要求下,广泛的质量项目和可靠性应与SIC结构一致。确定SIC限制并确定可靠的工作条件很重要。了解失败和机制的方式至关重要。通过监视该故障的模式和机制,以及通过深度分析,弱点ES可以暴露并可以开发校正步骤。项目基金会与合作由于许多SIC的高性能应用程序也涉及具有长寿周期的系统,因此SIC测试与应用程序期望非常一致,这一点很重要。为了加深对硅碳化材料的故障模式的理解,半项目的质量包括不同的团队,包括参与前端制造,研发,申请审查和失败审查的团队。通过在全球大学和专业的研究中,合作进一步加强了该项目。晶圆质量认证晶体质量认证(也称为内在质量认证)着重于制造晶圆的过程,其目的是确保所有根据合格流程处理的所有晶片都具有稳定的高水平高度。这可能是任何SIC可靠性中最关键的因素,作为晶圆缺陷S既可以在包装过程中立即导致立即失败,也可能导致产品的最后生活中的问题。为了确保长期的可靠性,半导体中已经开发了一系列深层技术,包括旨在消除缺陷谷物的幕后和电子筛选工具。制作晶片的过程始于基板,该过程使用监视坐标和自动分类技术来识别和监视缺陷。在整个劳动过程中,许多检查扫描已被用来在关键步骤中识别潜在的缺陷(图3)。图3在前头过程中的扫描和审查电气筛选也在多个阶段进行,例如晶圆接收测试,累积的测试和晶粒晶粒的分类以及动态组件的平均测试,以消除电气异常值。最后,所有晶圆都需要进行彻底的自动检查,包括识别视觉缺陷。如果在详尽的SIC产品开发或在产品连续生产过程中,在半导体中进行了一系列旨在测试整个制造过程的质量和可靠性(WAFER生产,产品包装和应用程序测试),则进行了广泛的测试。半导体的分解电荷(QBD)测试使用QBD作为评估门氧化物质量,独立的门氧化物厚度的直接有效程序。 Onsemi的程序将在室温下对正向偏置门应用于当前的5 mA/cm²,这是一种破坏性测试,超过了QBD的线性电压测试,其准确性和敏感性可以检测内在分布的细微差异。图4显示了与平面SIC的性能和门氧化物相比的内在比较结果。图4比较性能时,QBD PARA与SIC NMOS的电容器,1200 V40MΩ精英MOSFET和MOSFET产品的测量值内在QBD(无论门的氧化物厚度如何),在相同的名义厚度下,Onsem平面SIC的内在性能是SI的50倍。它显示出对性能和可靠性的SIC的巨大跳跃。在分娩过程中,通过比较SIC MOSFET产品晶粒的QBD样品(2.7 mm x 2.7 mm)NMOS电容器来评估每个批次的门氧化物质量,并设置了严格的标准标准以确保除去任何异常值。 TDB测试以确保其SIC产品的终身寿命,在半导体中进行了广泛的TDDB应力测试,进一步超过了常规的操作条件。图5显示了TDB测试数据FORSIC生产MOSFET的实例。 Ang aparato ay sumailalim sa isang serye ng mga boltahe ng gate at isang patlang na electric ng oxide na nauugnay sa pagkuha ng elektron sa temperatura na 175 ° C. Larawan 5 SiC Ang data ng TDDB para sa paggawa ng MOSFETS (175OC at stress sa ibaba 9 mV/cm) kahit na may Isang KonserbatiBong Modelo,Ang Hinulaang oras ng pagkabigo ay 20 taon na may iSang boltahe ng门Ng 21V,Na Mas Mas Mataas Kaysa kaysa sa操作电压,该操作电压由该模型(18V)指定。除了QBD和TDB测试外,半导体还在公司内部进行了广泛的实验,并具有独立的学术研究人员。包括双极老化,动态应力测试和BTI老化测试在内的全范围测试过程,为晶圆到决赛应用产品的综合测试提供了一种广泛的跨功能方法。这样可以确保在SEM Productsi中提供SIC的承诺 - 提高效率,转移速度,支持更高的电压和增强可靠性,从而更准确地满足客户系统的要求。 2023年11月,该半岛在斯洛伐克佩斯塔尼(Piestany)开设了高级电动汽车系统应用实验室,该实验室进一步扩大了其应用程序的测试范围。该实验室旨在支持下一代Solu的发展电动车辆和可变的能源逆变器的电源。该实验室包括各种所有权测试以及来自已知行业的制造商(例如AVL)的解决方案。在市场上为大规模SIC采用的硅碳化物 - 碳化物 - 技术也将面临挑战,例如半导体制造商维持需求,并且不应记住电子工业的SIC的可靠性和性能,这要归功于广泛的测试测试,例如由半导体进行的测试。 SIC技术应该是工程师增加苛刻应用的首选,包括电动车辆和可变的能源转换。以前,电子工程师很难找到解决方案和应用水平的解决方案,这些解决方案在市场上推出时立即跳入性能和可靠性,但这可以通过SIC技术来完成。
本文的上述地址:从MOSFET,二极管到电源模块,功率半导体产品是我们生活中无数的无数电子设备。从医疗设备和改良的能源基础设施到个人电子和电动车辆(EV),它们的性能和可靠性可确保各种设备的持续运行。第三代宽带隙解(WBG)领先于半导体技术,例如使用硅杆(SIC)。与传统的硅晶体管(SI)相比,SIC的良好物理特性使基于SIC的系统可显着减少损失并加速过渡到较小的形态。由于SIC在市场上是相对较新的,因此一些工程师犹豫不决在确定技术可靠性水平之前从SI到SIC。但是,等待本身也会带来风险 - 因为硅carbaan提高了性能,因此采用技术的延迟会导致失去优于竞争市场的优势。在本文中,我们探讨了SIC半导体产品如何实现高质量和可靠性,以及SIC制造商为确保可以将其解决方案置于市场上的巨大努力,这不仅可以提高产品性能,还可以确保良好的可靠性。 SIC半导体之间有什么区别?在化学水平上,SI和SIC之间的差异是碳原子的唯一增加。但是,与较弱的钻石类型相比,它导致SIC晶圆是wurtzite型原子结构更加困难。这种结构差异使SIC具有提高机械稳定性,出色的导热率,较低的热膨胀系数和在高温下较大的频带。增加的层间带宽会导致半导体从绝缘状态转移到导电状态到更高的阈值。第三代半导体的移动阈值范围在2之间。3个电子伏(EV)和3.3电子伏(EV),而第一代和第二代半导体的移动阈值在0.6至1.5 eV之间。 。因此,它们具有较高的稳定性,更高的可靠性,通过降低功率损失来提高效率,并且较高的温度阈值与硅半导体相比。对于电子行业,它可以提高现有设计的效率,并促进电动车辆的开发,并转换能量转换为更高的电压。这将带来更多的好处,例如减少原材料和冷却要求(由于电流减少到相同的功率),减少系统尺寸和重量,并减少电动汽车的充电时间。 。这对于关键能源基础设施(例如快速速度直流,电池能量存储系统和工业太阳逆变器)的组件尤其重要。从严格的停机时间维修到丧失品牌声誉,甚至更大的损失或损坏,确保这些物质的可靠性很重要。在高压SIC应用中,常见的障碍率相对较大。诸如功率周期,热不稳定性和瞬态,电子运动和低功率场之类的因素会导致在设备整个寿命中的半导体过早故障。偏置温度不稳定性(BTI)BTI是累积影响硅产品可靠性的常见现象。在介电界面中或附近,由于界面的界面陷阱的出现,这种现象将导致抗性增加,从而降低阈值电压并降低运动速度。负偏置温度不稳定性(NBTI)是MOSFET可靠性的主要问题之一,通常逐渐以晶体管年龄的形式出现。如果闸门到源电压为负或栅极为AP,则这对于设备尤其明显带有负偏置电压。时间取决于氧化物分解门(TDDB)TDDB是指由于持续的施加电压电压以及操作过程中地球电磁辐射的影响,因此氧化门可能会损坏栅极氧化。这是一种基于衰老的失败的机制,它限制了半导体产品的使用寿命。强度和热量会影响设备中的剧烈电循环会增加MOSFET的直接应力,并会产生超出击穿电压的电压尖峰。虽然抑制措施可以帮助减少手术随着时间的影响,但即使动态压力较弱也会影响设备的可靠性。由于半导体材料本身的结构是操作的关键,因此当基板的不同区域冷却并以不同的速度撤退时,强烈和重复的热周期可能会损害该物质。由SIC MOSFET体二极管C的应力引起的双极性双极积累导致偏置向前流过人体二极管引起的状态电阻“ ON”的增加。该积累偶尔显示为正向电压漂移或闭合状态下增加的泄漏电流。最常见的是,这种激活是由激活现有的外延层晶体晶体位错(BPD)引起的,可以通过合理设计外xial层和在分娩过程中进行扫描来预防。确保SIC制造商之一Onemi的半导体可靠性,以确保将SIC产品藏在随后的一代应用程序的性能要求下,广泛的质量项目和可靠性应与SIC结构一致。确定SIC限制并确定可靠的工作条件很重要。了解失败和机制的方式至关重要。通过监视该故障的模式和机制,以及通过深度分析,弱点ES可以暴露并可以开发校正步骤。项目基金会与合作由于许多SIC的高性能应用程序也涉及具有长寿周期的系统,因此SIC测试与应用程序期望非常一致,这一点很重要。为了加深对硅碳化材料的故障模式的理解,半项目的质量包括不同的团队,包括参与前端制造,研发,申请审查和失败审查的团队。通过在全球大学和专业的研究中,合作进一步加强了该项目。晶圆质量认证晶体质量认证(也称为内在质量认证)着重于制造晶圆的过程,其目的是确保所有根据合格流程处理的所有晶片都具有稳定的高水平高度。这可能是任何SIC可靠性中最关键的因素,作为晶圆缺陷S既可以在包装过程中立即导致立即失败,也可能导致产品的最后生活中的问题。为了确保长期的可靠性,半导体中已经开发了一系列深层技术,包括旨在消除缺陷谷物的幕后和电子筛选工具。制作晶片的过程始于基板,该过程使用监视坐标和自动分类技术来识别和监视缺陷。在整个劳动过程中,许多检查扫描已被用来在关键步骤中识别潜在的缺陷(图3)。图3在前头过程中的扫描和审查电气筛选也在多个阶段进行,例如晶圆接收测试,累积的测试和晶粒晶粒的分类以及动态组件的平均测试,以消除电气异常值。最后,所有晶圆都需要进行彻底的自动检查,包括识别视觉缺陷。如果在详尽的SIC产品开发或在产品连续生产过程中,在半导体中进行了一系列旨在测试整个制造过程的质量和可靠性(WAFER生产,产品包装和应用程序测试),则进行了广泛的测试。半导体的分解电荷(QBD)测试使用QBD作为评估门氧化物质量,独立的门氧化物厚度的直接有效程序。 Onsemi的程序将在室温下对正向偏置门应用于当前的5 mA/cm²,这是一种破坏性测试,超过了QBD的线性电压测试,其准确性和敏感性可以检测内在分布的细微差异。图4显示了与平面SIC的性能和门氧化物相比的内在比较结果。图4比较性能时,QBD PARA与SIC NMOS的电容器,1200 V40MΩ精英MOSFET和MOSFET产品的测量值内在QBD(无论门的氧化物厚度如何),在相同的名义厚度下,Onsem平面SIC的内在性能是SI的50倍。它显示出对性能和可靠性的SIC的巨大跳跃。在分娩过程中,通过比较SIC MOSFET产品晶粒的QBD样品(2.7 mm x 2.7 mm)NMOS电容器来评估每个批次的门氧化物质量,并设置了严格的标准标准以确保除去任何异常值。 TDB测试以确保其SIC产品的终身寿命,在半导体中进行了广泛的TDDB应力测试,进一步超过了常规的操作条件。图5显示了TDB测试数据FORSIC生产MOSFET的实例。 Ang aparato ay sumailalim sa isang serye ng mga boltahe ng gate at isang patlang na electric ng oxide na nauugnay sa pagkuha ng elektron sa temperatura na 175 ° C. Larawan 5 SiC Ang data ng TDDB para sa paggawa ng MOSFETS (175OC at stress sa ibaba 9 mV/cm) kahit na may Isang KonserbatiBong Modelo,Ang Hinulaang oras ng pagkabigo ay 20 taon na may iSang boltahe ng门Ng 21V,Na Mas Mas Mataas Kaysa kaysa sa操作电压,该操作电压由该模型(18V)指定。除了QBD和TDB测试外,半导体还在公司内部进行了广泛的实验,并具有独立的学术研究人员。包括双极老化,动态应力测试和BTI老化测试在内的全范围测试过程,为晶圆到决赛应用产品的综合测试提供了一种广泛的跨功能方法。这样可以确保在SEM Productsi中提供SIC的承诺 - 提高效率,转移速度,支持更高的电压和增强可靠性,从而更准确地满足客户系统的要求。 2023年11月,该半岛在斯洛伐克佩斯塔尼(Piestany)开设了高级电动汽车系统应用实验室,该实验室进一步扩大了其应用程序的测试范围。该实验室旨在支持下一代Solu的发展电动车辆和可变的能源逆变器的电源。该实验室包括各种所有权测试以及来自已知行业的制造商(例如AVL)的解决方案。在市场上为大规模SIC采用的硅碳化物 - 碳化物 - 技术也将面临挑战,例如半导体制造商维持需求,并且不应记住电子工业的SIC的可靠性和性能,这要归功于广泛的测试测试,例如由半导体进行的测试。 SIC技术应该是工程师增加苛刻应用的首选,包括电动车辆和可变的能源转换。以前,电子工程师很难找到解决方案和应用水平的解决方案,这些解决方案在市场上推出时立即跳入性能和可靠性,但这可以通过SIC技术来完成。